- 电话:021-50456736
- 邮箱:v@riyngroup.com
正性光刻胶系列 * UIV - G6003B(粘度4.5CP) * UIV - G6013B(粘度13CP)
- 我们开发了性能优异的正性光刻胶系列产品:G6003B/G6013B.
-
我们开发的正性光刻胶,在分辨率、对比度、敏感度、抗腐蚀性等方面均有优异的表现,
被广泛应用于:模拟半导体、发光二极管、光电子器件/光子器件、封装(Packaging)等领域
| 基本信息 | ||
| 英文名 | photoresist | |
| 别名 | 光致抗蚀剂 | |
| 中文名称 | 光刻胶,正性光刻胶 | |
| 光刻胶实物图 |
 |
|
| 用 途: |
适用于TP、TN-LCD、STN-LCD 图形制作段光刻
|
|
| 涂布方式: | 辊涂,旋涂 | |
|
包 装:
|
PP 瓶,外套两层遮光的黑色PE 袋 1 加仑/瓶(3.78L/瓶),4 瓶/箱 |
|
|
保 存:
|
5~25℃避光存放,远离热源、火种。储存于5~25℃的温度下且未打开瓶盖
时的储存期限为制造后9 个月。
|
|
| 注意事项: | 需在通风良好的条件下使用,在黄光室才能打开包装 | |
| 推荐工艺: |
涂胶 辊涂、旋涂
使用粘度 4~13 CP
涂胶厚度 1.2~1.8μm
前烘 95±5℃,90sec
曝光 80mj/cm2
显影 0.8% KOH 水溶液, 90sec,23℃
漂洗 DI 水,30sec
后烘 120 ℃,120sec(热板)或120 ℃,20~30min(烘箱)
蚀刻 FeCL3/HCL(35%)/H2O=1/2/1, 45℃,
去膜 3~5% NaOH 水溶液, 120sec,45℃
漂洗 DI 水 ≥ 120sec
|
|
产品应用领域
模拟半导体(Analog Semiconductors)、发光二极管(Light-Emitting Diodes LEDs)、微机电系统(Microelectromechanical Systems MEMS)、太阳能光伏(Solar Photovoltaics PV)、微流道和生物芯片(Microfluidics & Biochips)、封装(Packaging)、光电子器件/光子器件(Optoelectronics/Photonics)
光刻胶技术文档.Pdf
涂布曲线、曝光影响因素、显影影响因素、侧向腐蚀的影响因素、去膜影响因素




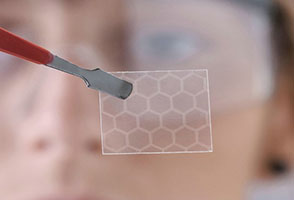






![2-氯-4,6-二(9,9-二甲基-9H-芴)-1,3,5-三嗪[1459162-69-6]](/uploads/160304/2-160304160254Y6.jpg)
![2,4-二([1,1'-联苯]-4-基)-6-氯-1,3,5-三嗪 [182918-13-4]](/uploads/160304/2-160304155Z0E9.jpg)
![2-[1,1'-联苯]-4-基-4-氯-6-苯基-1,3,5-三嗪 [1472062-94-4]](/uploads/160304/2-160304160143B2.jpg)





